芯片键合,作为切割工艺的后道工序,是将芯片固定到基板(substrate)上的一道工艺。引线键合(wire bonding)则作为芯片键合的下道工序,是确保电信号传输的一个过程。wire bonding是最常见一种键合方式。焊线封装工艺:用导线将半导体芯片上的电极与外部引脚相连接的工艺,即完成芯片与封装外引脚建的电流通路。
这些微小产品的拉力测试方法是:拉力测试时以靠近焊球金线弧形最高处为基准,如下图所示:
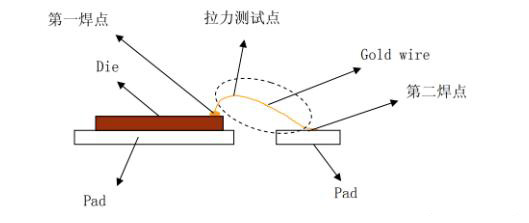
这些微小产品的拉力测试方法是:拉力测试时以靠近焊球金线弧形最高处为基准,如下图所示:
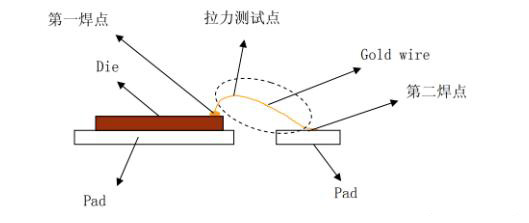
Wire Bond/金线键合: 指在对芯片和基板间的胶粘剂处理以使其有更好的粘结性能后,用高纯金线把芯片的接口和基板的接口键合。
成分为金(纯度为99.999%),掺杂银、钯、镁、铁、铜、硅等元素。掺杂不同的元素可以改变金线的硬度、刚性、延展度、电导率等参数。
Gold Bonding Wire: 半导体键合金线/金丝
用于半导体封装工艺中的芯片键合。
使用到的设备是:芯片金线拉力测试机
设备特点:
1.所有传感器采用高速动态传感及高速数据采集系统,确保测试数据的准确无误。
2.采用公司独特研发的高分辨率(24 BitPlus超高分辨率)的数据采集系统。
3.采用公司独有的安全限位及安全限速技术,让操作得心应手。
4.采用公司独有的智能灯光控制与调节系统,减少光源对视力的损伤。
5.标配高清观察显微镜,减少人员视觉疲劳。
6.双摇杆四向操作及人性化的软件配置使操作简单、方便。
7.结合人体学的独特设计,让使用更加舒适。
8.设备全方位的保护措施,避免因人员误操作对设备的损坏。
9.强大的研发实力,根据客户的需求提供订制化产品。
10.贴心的售后服务,让使用人员无后顾之忧。
测试模块范围:
| 推力测试-金球/晶片 | 测试范围 | 拉力测试-焊线 | 测试范围 |
| BS250G | 25g、50g、100g、250g | WP25G | 2.5g、5g、10g、25g |
| BS1KG | 100g、250g、500g、1kg | WP50G | 5g、10g、25g、50g |
| DS5KG | 500g、1kg、2.5kg、5kg | WP100G | 10g、25g、50g、100g |
| DS10KG | 2.5kg、5kg、7.5kg、10kg | WP200G | 25g、50g、100g、200g |
| DS20KG | 2kg、4kg、10kg、20kg | WP1KG | 100g、250g、500g、1kg |
| DS50KG | 10kg、20kg、40kg、50kg | WP5KG | 500g、1.25kg、2.5kg、5kg |
| DS100KG | 10kg、20kg、50kg、100kg | WP10KG | 1kg、2.5kg、5kg、10kg |
| DS200KG | 20kg、40kg、100kg、200kg | WP20KG | 2.5kg、5kg、10kg、20kg |
| 压力测试 | 测试范围 | 镊拉力测试 | 测试范围 |
| PP100G | 10g、25g、50g、100g | TP100G | 10g、25g、50g、100g |
| PP5KG | 500g、1.25kg、2.5kg、5kg | TP1KG | 100g、250g、500g、1kg |
| PP50KG | 5kg、10kg、25kg、50kg | TP5KG | 500g、1.25kg、2.5kg、5kg |
| 可根据客户需求,定制不同量程测试模块 | |||


